0. 이전 이야기
1강에서는 반도체 패키징의 주요 역할에 대해 포스팅하였음. 반도체 패키징의 주요 역할로는 전기적 연결, 기계적 보호 및 연결, 열 분산, 패턴 차이 보상 그리고 신뢰성 확보 등이 있음
https://nate0707.tistory.com/167
【반도체 패키징】 1강-반도체 패키징이란
0. 서론블로그 포스팅은 반도체설계교육센터에서 진행하는 충북대학교 권정현 교수의 강의를 토대로 작성됨반도체가 만들어지기 위해서는 반도체의 전공정+후공정이 필요함주로 우리가 아는
nate0707.tistory.com
1. 반도체 패키징의 고려사항
- 열 방출
반도체 장치의 성능과 수명을 유지하려면 효과적인 열 관리는 필수적임
과열되면 성능 저하나 칩 고장이 발생할 수 있기 때문에, 열 방출을 최적화하는 기술이 필요함
- 고속 전기 신호 전송
고속 장치에 대한 수요가 증가함에 따라, 고속 전기 신호 전송은 매우 중요한 요소임
패키징은 신호 지연과 간섭을 최소화해야 하며, 이를 통해 고주파 통신을 지원함
- 3차원 칩 적층
장치의 크기가 계속 줄어들면서, 칩을 수직으로 쌓는 3D 패키징 기술이 칩 밀도를 높이면서 장치의 부피를 확장하지 않는 효과적인 방법으로 인식되고 있음
이를 통해 컴팩트한 디자인과 성능 향상을 달성할 수 있음
- 소형화
반도체 패키지의 크기를 줄이는 것은 소비자 전자기기, 의료기기, IoT 애플리케이션 등에서 매우 중요함
소형 패키지는 더 작은 기기 디자인을 가능하게 하고, 휴대성을 증가시킴
- 신뢰성
패키징은 수분과 산소로부터 칩을 보호해야 하며, 부식이나 열화가 발생하지 않도록 해야 함
또한, 워페이지(기판이나 칩의 변형)가 발생하지 않도록 관리해야 하며, 이러한 문제를 해결하는 데 필요한 기술과 재료를 선택하는 것이 중요함
2. 기존과 현대의 반도체 패키징
기존의 패키징 방식에서는 하나의 칩을 하나의 패키지에 넣었음
그러나 다수의 칩을 하나의 패키지에 통합하는 최신 패키징 방식이 요구되고 있으며, 이로 인해 공간 절약과 성능 향상 등의 장점이 있음
3. 반도체 패키징 기술
- 플립칩 (Flip Chip)
플립칩 패키징에서는 칩을 뒤집어서, 칩의 패드와 기판의 패드를 직접 연결함
이 방식은 와이어 본딩에 비해 더 빠르고 효율적인 연결을 제공함
고성능 애플리케이션에 자주 사용됨
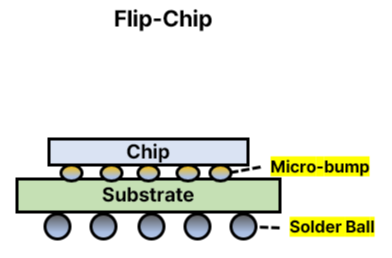
- 와이어 본딩 (Wire Bonding)
와이어 본딩은 칩의 패드를 패키지 리드와 연결하기 위해 금선이나 알루미늄 와이어를 사용하는 방식임
비교적 간단한 방식이지만, 고속 또는 고성능 애플리케이션에는 플립칩보다는 효율성이 떨어질 수 있음
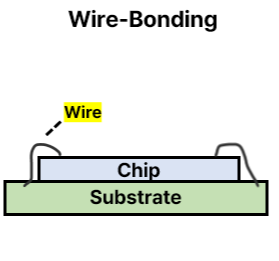
- 패키지 온 패키지 (PoP)
PoP는 메모리와 비메모리 반도체 패키지의 수직 적층을 의미함
여러 개의 반도체 칩을 세로로 결합하여 패키지의 공간 효율성을 극대화함
- 시스템 인 패키지 (SiP)
SiP는 여러 개의 반도체 칩을 하나의 패키지에 결합하여, 하나의 모듈 내에서 다양한 기능을 수행하도록 하는 기술임
이 방식은 시스템의 성능을 높이고, 소형화 및 비용 절감을 목표로 함
- 2.5D 패키징
2.5D 패키징은 여러 개의 2D 칩을 수평으로 배열하고, 이를 인터포저라는 중간 기판을 통해 연결하는 기술임
3D 패키징보다는 단순하면서도 집적도를 높일 수 있는 방법으로, 수직 연결이 추가된 형태임
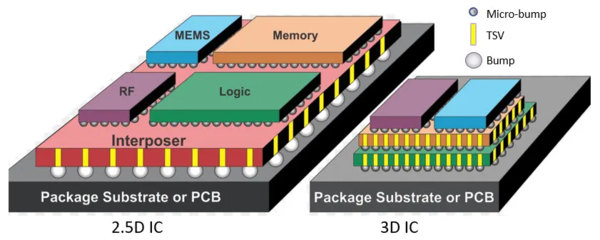
2.5D 패키징은 여러 반도체 칩을 수평으로 배치해 하나의 패키지로 통합하는 기술로, 칩 간 연결을 위해 기판과 칩 사이에 실리콘 인터포저를 사용하는 것이 특징임
이 기술은 3D와 유사한 성능을 제공하면서도 발열 문제를 비교적 잘 해결하며, 특히 HBM(High Bandwidth Memory)과 같은 고밀도 집적을 위해 효율적인 방법으로 각광받고 있음
4. 최신 패키징 기술
- 웨이퍼 레벨 패키징 (WLP)
WLP는 반도체 칩을 웨이퍼 상태에서 패키징하는 기술임
개별적으로 칩을 처리하기 전에 웨이퍼에서 전기적 연결과 보호막을 형성함
이는 생산 효율성을 높이고, 대량 생산에 유리한 방법임

- 패널 레벨 패키징 (PLP)
PLP는 웨이퍼 대신 큰 패널을 사용하여 패키징을 진행하는 방식임
패널은 웨이퍼보다 크고 평평한 기판으로, 대량 생산에 유리한 점이 있음
사각형 모양의 기판을 사용하여 집적도를 높일 수 있음
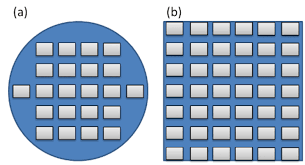
- RDL (Redistribution Layer)
RDL은 기판 위에 배선 레이어를 추가하여, 패드 배치나 배선 경로를 재분배하는 기술임
이 기술은 전통적인 PCB 기판을 대체할 수 있으며, 웨이퍼 레벨에서 RDL을 형성한 후 패키징에 활용됨
주로 2.5D 또는 2.3D 패키징 기술에 사용되며 효율적인 전력관리, 소형화, 고속 신호 전달의 역할을 함
'공부 > 【반도체 패키징】' 카테고리의 다른 글
| 【반도체 패키징】 7강-반도체 패키지에서의 구조해석 (0) | 2025.02.22 |
|---|---|
| 【반도체 패키징】 5강-Advanced Package 공정의 이해: TSV, WLP, PLP (1) | 2025.02.20 |
| 【반도체 패키징】 4강-Conventional Package의 Back-End 공정 (0) | 2025.02.19 |
| 【반도체 패키징】 3강-컨벤셔널 패키지와 플립칩 패키지 (0) | 2025.02.19 |
| 【반도체 패키징】 1강-반도체 패키징의 정의와 역할 (0) | 2025.02.18 |