0. 서론
블로그 포스팅은 반도체설계교육센터에서 진행하는 충북대학교 권정현 교수의 <반도체 패키징> 강의를 토대로 작성됨
반도체가 만들어지기 위해서는 반도체의 전공정+후공정이 필요함
주로 우리가 아는 반도체 8대 공정은 전공정에 해당하고, 생산된 반도체를 패키지하는 반도체 패키징은 후공정에 해당함
1. 반도체 패키징이란?
반도체 패키징(Semiconductor Packaging)은 웨이퍼(Wafer) 또는 칩(Chip)의 특성을 구현한 후 이를 제품화하는 과정임. 단순히 칩을 보호하는 것뿐만 아니라 전기적 연결과 방열(Heat Dissipation) 등의 역할도 수행함
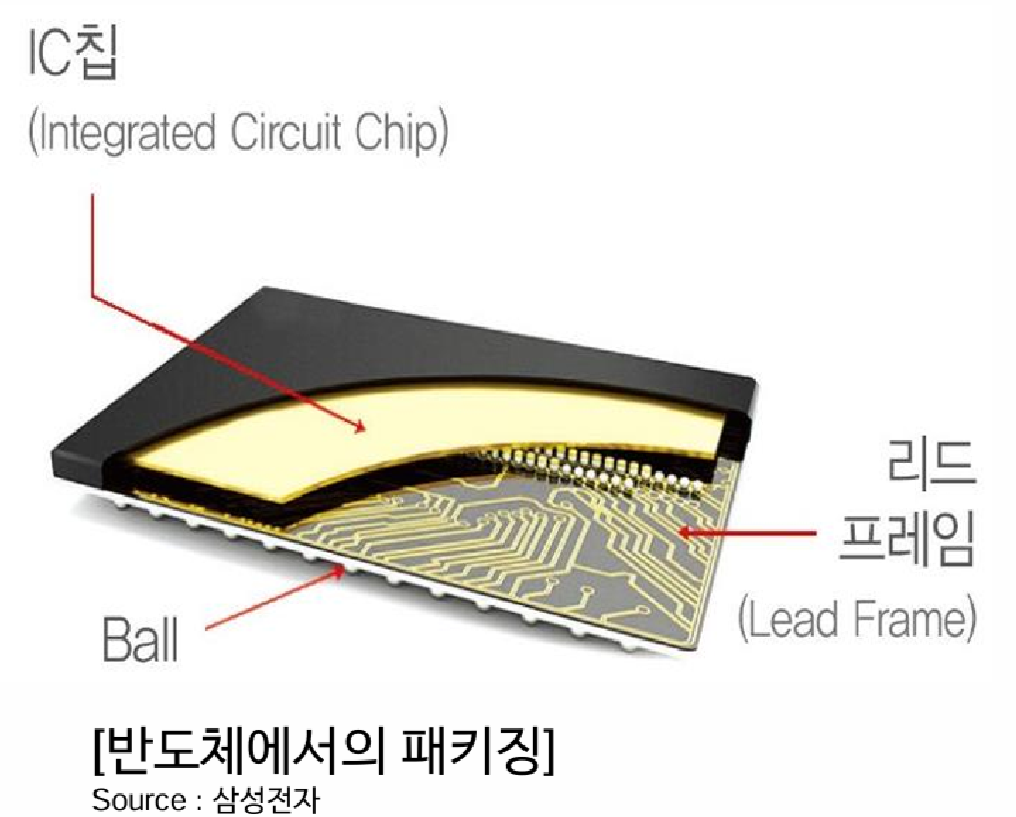
패키징 과정에서는 내부와 외부 연결 작업이 이루어짐
- 내부 연결 작업 : 와이어 본딩(Wire Bonding) 또는 플립칩 마운트(Flip-Chip Mount) 방식으로 칩과 기판을 연결함
- 외부 연결 작업 : 솔더 볼 부착(Solder Ball Attach)을 통해 칩을 PCB(Printed Circuit Board)에 부착함
2. 반도체 패키징의 주요 역할
- 전기적 연결
반도체 칩과 기판 사이의 신호를 원활하게 전달하는 것이 패키징의 가장 기본적인 역할임
이를 위해 내부적으로는 와이어 본딩 또는 플립칩 마운트 기술이 사용됨
와이어 본딩: 가는 금속 와이어로 칩과 기판을 연결하는 방식
플립칩 마운트: 칩에 솔더 범프(Solder Bump)를 형성한 후 뒤집어 기판에 직접 부착하는 방식
- 기계적 보호 및 연결
실리콘(Si) 웨이퍼는 깨지기 쉬운 특성을 가짐
따라서 외부 충격이나 환경적 요인으로부터 보호하는 것이 중요함
이를 위해 몰딩(Molding) 과정이 포함됨
몰딩(Molding): 에폭시 몰딩 컴파운드(EMC, Epoxy Molding Compound)로 칩과 기판을 감싸 보호함, 몰딩을 통해 기계적 강도, 전기적 절연, 환경 보호(수분, 오염, 충격 방지) 기능이 강화됨
* EMC(Epoxy Molding Compound)는 반도체 패키징 공정에서 칩을 보호하는 봉지재(Encapsulant)로, 열에 의해 경화되는 열경화성 에폭시 고분자 재료와 무기 실리카 재료를 혼합한 복합 재료임, 이 재료는 반도체 칩을 감싸 외부 환경으로부터 보호하며, 패키지의 신뢰성을 높이는 핵심 요소임
주로 물리적-화학적 보호, 열 방출 기능, 형상 유지 그리고 우수한 접착성의 역할을 함
- 열 분산(Heat Dissipation)
반도체 칩이 동작할 때 발생하는 열을 제대로 방출하지 않으면 성능 저하와 수명 단축 문제가 발생함
따라서 열 관리는 필수적인 요소인데, 실리콘의 열팽창계수(CTE, Coefficient of Thermal Expansion)는 약 2.7로 낮은 반면 금속 등 다른 소재들과 팽창 정도가 큼
이 차이를 보완하기 위해 EMC, PCB 기판, 언더필(Underfill) 등 다양한 소재가 사용됨. 히트싱크(Heat Sink)나 서멀 인터페이스(Thermal Interface Material, TIM) 등을 추가해 열을 더욱 효율적으로 분산하기도 함
- 패턴 차이 보상
칩과 기판 간의 패턴 차이로 인해 신호 전송 문제가 발생할 수 있음. 이를 해결하기 위해 패키징 과정에서 최적화 작업이 이루어짐
- 신뢰성 확보
반도체 패키징의 최종 목표는 신뢰성(Reliability) 확보임, 엔캡슐레이션(Encapsulation) 또는 패시베이션(Passivation, 봉지) 과정을 통해 칩을 보호함
* 봉지공정: 반도체 소자상부에 EncapFilm, Glass 또는 Metal Can 등을 이용하여 외기가 침투하지 못하도록 밀폐시키는 공정으로 반도체를 구성하는 박막들이 대기 중의 산소 및 수분을 완벽히 차단하여, Device의 수명을 보존 및 향상하기 위함임
* 신뢰성: 고온, 저온, 다습한 환경 등에서 반도체 칩이 정상적으로 작동할 수 있는 능력을 의미
이때 신뢰성을 수분투과율로 나타내기도 하는데, 반도체 수명에 영향을 미치는 요소 중 하나인 WVTR(Water Vapor Transmission Rate, 수분 투과율)을 이용함
특히 OLED나 반도체 소자에서는 수분 침투가 제품의 신뢰성에 큰 영향을 미칠 수 있음
3. 반도체 신뢰성
품질: 제품의 정해진 요구 기준과 특성 충족 여부, 제품을 만들고 검사하는 도중 발생하는 불량을 결함(Defect)임
신뢰성: 어떤 시스템이나 부품, 소재 등이 주어진 조건(사용, 환경조건)에서 고장 없이 일정기간(시간, 거리, 횟수) 동안 최최초의 품질 및 성능을 유지하는 특성, 실제 사용 중 발생된 불량은 고장(Failure)임
수명 신뢰성 시험, 환경 신뢰성 시험, 기계적 신뢰성 시험 등 다양한 신뢰성 시험이 진행됨
'공부 > 【반도체 패키징】' 카테고리의 다른 글
| 【반도체 패키징】 7강-반도체 패키지에서의 구조해석 (0) | 2025.02.22 |
|---|---|
| 【반도체 패키징】 5강-Advanced Package 공정의 이해: TSV, WLP, PLP (1) | 2025.02.20 |
| 【반도체 패키징】 4강-Conventional Package의 Back-End 공정 (0) | 2025.02.19 |
| 【반도체 패키징】 3강-컨벤셔널 패키지와 플립칩 패키지 (0) | 2025.02.19 |
| 【반도체 패키징】 2강-반도체 패키지와 개발 트렌드 (0) | 2025.02.18 |